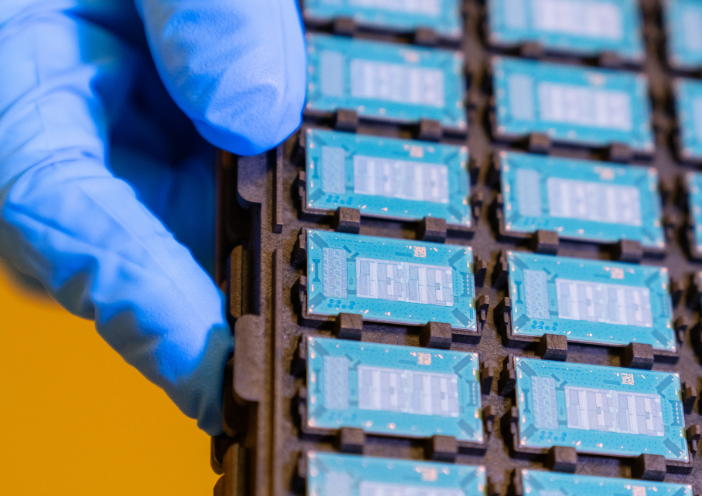
Dalam penerokaan pembungkusan termaju, Intel telah menumpukan perhatiannya kepada bahan baharu untuk substrat cip: kaca. Ketegaran kaca, bersama dengan pekali pengembangan haba yang lebih rendah, menjadikannya lebih baik daripada substrat organik, kerana ia mengurangkan tahap pengembangan dan meledingkan. Menurut Pooya Tadayon, Felo Intel dan Pengarah Pembangunan Teknologi Pembungkusan dan Ujian, sifat ini memberi kaca kelebihan tertentu dalam penskalaan proses, seperti mencapai nada yang lebih halus.

Tom Rucker, Naib Presiden Pembangunan Teknologi dan Pengarah Penyepaduan Pembangunan Teknologi Pembungkusan dan Ujian di Intel
"Menggunakan substrat kaca membolehkan kami memperkenalkan beberapa fungsi dan geometri yang menarik untuk meningkatkan penghantaran kuasa," kata Tadayon. "Bahan ini juga boleh mendayakan diod berkelajuan tinggi yang melangkaui 224G dan juga mencapai 448G." Beliau menambah bahawa penggunaan substrat kaca adalah proses beransur-ansur, didorong oleh pembangunan alat dan proses, serta permintaan yang semakin meningkat. Substrat kaca akan wujud bersama substrat organik dan bukannya menggantikannya.

Tom Rucker, Naib Presiden Pembangunan Teknologi dan Pengarah Penyepaduan Pembangunan Teknologi Pembungkusan dan Ujian di Intel, menyatakan bahawa syarikat itu telah mengalihkan tumpuannya dalam pembungkusan lanjutan daripada sistem-pada-cip (SoC) kepada sistem-dalam-pakej (SiP).
"Apabila kami mengalihkan banyak barisan produk kami untuk menggunakan teknologi Jambatan Sambung Berbilang Mati Terbenam (EMIB), anjakan ini terus mendapat momentum," kata Rucker. "Kami juga sedang bergerak ke arah sambung 3D, yang menyokong penyusunan die dan membolehkan peningkatan bilangan die, membolehkan geometri yang lebih kecil dan prestasi yang lebih tinggi-semuanya dalam satu pakej."

Pooya Tadayon, Felo Intel, Pengarah Pembangunan Teknologi Pembungkusan dan Pengujian
Cabaran mekanikal yang ditimbulkan oleh pembungkusan berskala besar juga telah mendorong Intel untuk mengembangkan keupayaannya dalam bidang ini. Tadayon menegaskan bahawa substrat terdedah kepada meledingkan, dan Mark Gardner, Pengarah Kanan Pembungkusan Termaju di Intel Foundry Services, menambah bahawa ini menyukarkan pemasangannya pada papan induk. "Hasilnya, kami mendapati bahawa mempunyai kepakaran dalam pemasangan papan boleh memberi manfaat kepada pelanggan kami, dan kami boleh bekerjasama dengan pengeluar pemasangan papan untuk menyediakan proses yang lancar untuk mereka," jelas Gardner.
Memacu Inovasi Berterusan dalam Teknologi Pembungkusan
Produk Intel yang baru dilancarkan dan akan datang termasuk:
- . Siri Maks GPU pusat data, yang diperkenalkan lebih awal pada tahun 2023, memanfaatkan hampir semua teknologi pembungkusan termaju Intel, termasuk susunan 3D bersebelahan dan EMIB. Komponen ini mengandungi 47 cetakan proses 5nm dan 100 bilion transistor.
- Generasi seterusnya 36µm pitch Foveros Teknologi susun 3D (yang telah berkembang daripada 50µm kepada 36µm dan kini kepada 25µm), serta Tasik Meteor pemproses, dijangka dilancarkan pada 2023.
- . Flip-Chip Ball-Grid-Array (FCBGA) platform, menyasarkan pengeluaran besar-besaran pada 2024, merancang untuk mengembangkan saiz pakej bersebelahan kepada 100mm, memanjangkan lapisan tengah dan mengurangkan pic kepada di bawah 90µm.
- Sambungan generasi seterusnya, termasuk gandingan berasaskan kaca—juga dikenali sebagai teknologi jambatan kaca—dan optik yang dibungkus bersama dengan pandu gelombang bersepadu.
Tadayon menjelaskan bahawa teknologi jambatan kaca tidak menyambung atau mengikat gentian optik secara langsung kepada cip silikon untuk mengelakkan pemprosesan semula. "Penyelesaian unik" ini menyokong kefungsian plug-and-play dan dijangka memasuki pengeluaran besar-besaran pada penghujung tahun 2024. Selain itu, teknologi tindanan cip Foveros Intel akan terus berkembang, dengan nada dijangka mengecil kepada 9µm.
"Melihat ke hadapan kepada teknologi generasi akan datang, kami merancang untuk menggunakan nada di bawah 5μm dalam produk kami," kata Tadayon. "Kami akan terus memperkenalkan seni bina baru dan keupayaan susun 3D, membolehkan arkitek menyambungkan cip dengan cara yang berbeza dan memanfaatkan fleksibiliti yang ditawarkan oleh platform ini."
Apakah yang Mendorong Inovasi Teknologi Ini?
"Teknologi pembungkusan memainkan peranan penting dalam membolehkan fungsi pengkomputeran merentas semua sektor ekosistem, daripada superkomputer berprestasi tinggi kepada pusat data, pengkomputeran tepi dan segala-galanya di antaranya—storan, penghantaran dan tindakan berdasarkan data," kata Rucker. "Pemacu utama untuk penyelesaian teknologi ialah prestasi, penskalaan dan kos."

Mark Gardner, pengarah kanan pembungkusan lanjutan di bahagian faundri Intel
Intel juga sedang memperhalusi perkhidmatan faundrinya, beralih daripada pendekatan "semua-atau-tiada". Gardner menerangkan model faundri sistem terbuka syarikat yang dirombak, yang menawarkan perkhidmatan à la carte yang lebih fleksibel meliputi keseluruhan kitaran hayat pembuatan produk—daripada spesifikasi produk kepada ujian.
"Pada masa lalu, anda perlu menggunakan semua perkhidmatan pembuatan kami atau tidak sama sekali," jelasnya. "Tetapi pendekatan baharu ini memenuhi permintaan dengan lebih berkesan dan menawarkan fleksibiliti yang lebih besar." Selain itu, ujian kini boleh dilakukan lebih awal dalam kitaran pembuatan, yang membantu mengurangkan kos.
"Ini amat penting kerana jika anda melihat Ponte Vecchio (nama kod untuk GPU pusat data Siri Max), ia mempunyai hampir 50 chiplet atau jubin," kata Gardner. "Sekiranya salah satu daripadanya gagal semasa ujian akhir, anda perlu membuang semua bekas lain yang baik, bersama-sama dengan pembungkusan yang sangat mahal. Kami telah melihat potensi untuk memperoleh lebih banyak daripada keupayaan ujian akhir."
