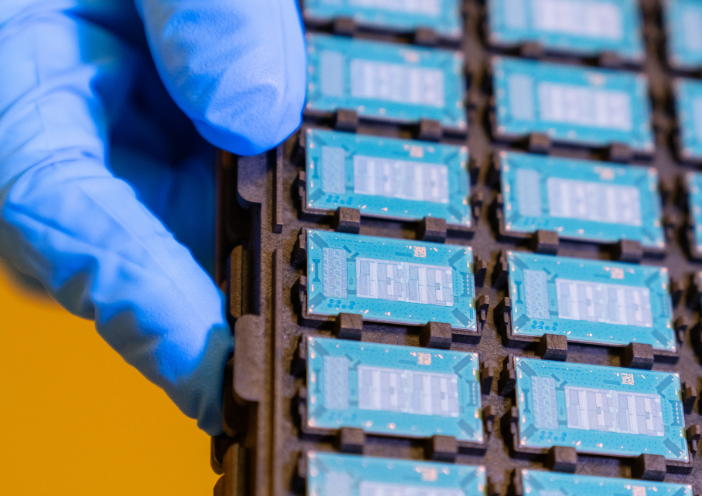
Im Rahmen seiner Forschung im Bereich Advanced Packaging hat Intel ein neues Material für Chipsubstrate ins Auge gefasst: Glas. Die hohe Steifigkeit und der geringere Wärmeausdehnungskoeffizient machen Glas organischen Substraten überlegen, da es Ausdehnung und Verformung reduziert. Laut Pooya Tadayon, Intel Fellow und Director of Packaging and Test Technology Development, bieten diese Eigenschaften Glas einen besonderen Vorteil bei der Prozessskalierung, beispielsweise bei der Erzielung feinerer Pitches.

Tom Rucker, Vizepräsident für Technologieentwicklung und Direktor für Verpackungs- und Testtechnologie-Entwicklungsintegration bei Intel
„Die Verwendung von Glassubstraten ermöglicht uns die Einführung interessanter Funktionalitäten und Geometrien zur Verbesserung der Stromübertragung“, sagte Tadayon. „Dieses Material ermöglicht auch Hochgeschwindigkeitsdioden, die über 224G hinausgehen und sogar 448G erreichen.“ Er fügte hinzu, dass die Einführung von Glassubstraten ein schrittweiser Prozess sei, der durch die Entwicklung von Werkzeugen und Prozessen sowie die steigende Nachfrage vorangetrieben werde. Glassubstrate werden neben organischen Substraten existieren, anstatt sie zu ersetzen.

Tom Rucker, Vice President of Technology Development und Director of Packaging and Test Technology Development Integration bei Intel, merkte an, dass das Unternehmen seinen Schwerpunkt im Bereich Advanced Packaging von System-on-Chip (SoC) auf System-in-Package (SiP) verlagert habe.
„Da wir viele unserer Produktlinien auf die Embedded Multi-Die Interconnect Bridge (EMIB)-Technologie umstellen, gewinnt dieser Wandel weiter an Dynamik“, so Rucker. „Wir setzen außerdem auf 3D-Verbindungen, die das Stapeln von Chips unterstützen und eine höhere Chipanzahl ermöglichen. Das ermöglicht kleinere Geometrien und höhere Leistung – und das alles in einem einzigen Gehäuse.“

Pooya Tadayon, Intel Fellow, Entwicklungsdirektorin für Verpackungs- und Testtechnologie
Die mechanischen Herausforderungen bei großflächigen Verpackungen haben Intel dazu veranlasst, seine Kapazitäten in diesem Bereich zu erweitern. Tadayon wies darauf hin, dass Substrate anfällig für Verformungen sind, und Mark Gardner, Senior Director of Advanced Packaging bei Intel Foundry Services, fügte hinzu, dass dies die Montage auf Motherboards erschwert. „Daher haben wir festgestellt, dass unsere Expertise in der Platinenmontage für unsere Kunden von Vorteil sein kann. Wir können mit Platinenherstellern zusammenarbeiten, um ihnen einen reibungslosen Prozess zu ermöglichen“, erklärte Gardner.
Kontinuierliche Innovation in der Verpackungstechnologie vorantreiben
Zu den neu eingeführten und kommenden Produkten von Intel gehören:
- Der Max-Serie Die Anfang 2023 eingeführten GPUs für Rechenzentren nutzen nahezu alle fortschrittlichen Verpackungstechnologien von Intel, darunter Side-by-Side-3D-Stacking und EMIB. Diese Komponenten enthalten 47 5-nm-Prozesschips und 100 Milliarden Transistoren.
- Die nächste Generation 36µm Pitch Foveros 3D-Stacking-Technologie (die sich von 50µm über 36µm bis hin zu 25µm weiterentwickelt hat) sowie die Meteorsee Prozessoren, deren Markteinführung für 2023 erwartet wird.
- Der Flip-Chip Ball-Grid-Array (FCBGA) Die Plattform zielt auf die Massenproduktion im Jahr 2024 ab und sieht vor, die Größe nebeneinander liegender Pakete auf 100 mm zu erweitern, die Mittelschichten zu erweitern und die Abstände auf unter 90 µm zu reduzieren.
- Verbindungen der nächsten Generation, einschließlich glasbasierter Kopplung – auch bekannt als Glasbrückentechnik– und gemeinsam verpackte Optiken mit integrierten Wellenleitern.
Tadayon erklärte, dass die Glasbrückentechnologie Glasfasern nicht direkt mit Siliziumchips verbindet, um eine erneute Aufbereitung zu vermeiden. Diese „einzigartige Lösung“ unterstützt Plug-and-Play-Funktionalität und soll bis Ende 2024 in die Massenproduktion gehen. Darüber hinaus wird sich Intels Foveros-Chip-Stacking-Technologie weiterentwickeln, wobei die Pitches voraussichtlich auf 9 µm sinken werden.
„Mit Blick auf die Technologien der nächsten Generation planen wir, in unseren Produkten Pitches unter 5 µm einzuführen“, sagte Tadayon. „Wir werden weiterhin neue Architekturen und 3D-Stacking-Funktionen einführen, die es Architekten ermöglichen, Chips auf unterschiedliche Weise zu verbinden und die Flexibilität dieser Plattform zu nutzen.“
Was treibt diese technologischen Innovationen voran?
„Verpackungstechnologie spielt eine entscheidende Rolle bei der Ermöglichung von Rechenfunktionen in allen Bereichen des Ökosystems, von Hochleistungs-Supercomputern über Rechenzentren bis hin zu Edge Computing und allem dazwischen – Speicherung, Übertragung und datenbasierte Aktionen“, sagte Rucker. „Die wichtigsten Treiber für technologische Lösungen sind Leistung, Skalierung und Kosten.“

Mark Gardner, Senior Director für Advanced Packaging bei Intels Foundry Division
Intel verfeinert zudem seine Foundry-Services und verabschiedet sich vom „Alles-oder-nichts“-Ansatz. Gardner beschrieb das überarbeitete Open-System-Foundry-Modell des Unternehmens, das flexiblere à-la-carte-Services für den gesamten Lebenszyklus der Produktherstellung bietet – von der Produktspezifikation bis zum Test.
„Früher musste man entweder alle unsere Fertigungsdienstleistungen in Anspruch nehmen oder gar nicht“, erklärte er. „Dieser neue Ansatz erfüllt die Nachfrage jedoch effektiver und bietet mehr Flexibilität.“ Außerdem können Tests jetzt früher im Fertigungszyklus durchgeführt werden, was zur Kostensenkung beiträgt.
„Das ist besonders wichtig, denn Ponte Vecchio (der Codename der Max-Serie für Rechenzentrums-GPUs) verfügt über fast 50 Chiplets oder Tiles“, sagte Gardner. „Wenn einer davon bei der Endprüfung ausfällt, müssen alle anderen guten Chips samt der sehr teuren Verpackung entsorgt werden. Wir haben erkannt, dass die Endprüfungsmöglichkeiten mehr Potenzial bergen.“
