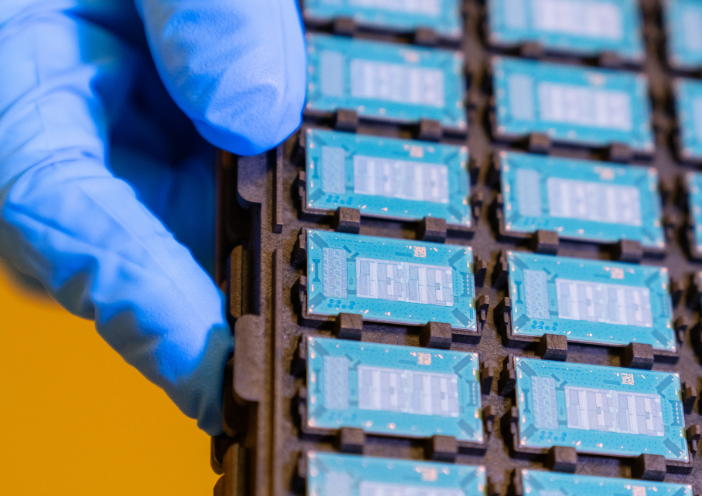
Intel, gelişmiş paketleme arayışında dikkatini çip alt tabakaları için yeni bir malzemeye çevirdi: cam. Camın sertliği ve daha düşük termal genleşme katsayısı, genleşme ve eğrilme derecesini azalttığı için onu organik alt tabakalardan üstün kılıyor. Intel Üyesi ve Paketleme ve Test Teknolojisi Geliştirme Direktörü Pooya Tadayon'a göre, bu özellikler cama daha ince hatveler elde etmek gibi süreç ölçeklendirmede özel bir avantaj sağlıyor.

Tom Rucker, Intel'de Teknoloji Geliştirme Başkan Yardımcısı ve Paketleme ve Test Teknolojisi Geliştirme Entegrasyonu Direktörü
Tadayon, "Cam alt tabakalar kullanmak, güç dağıtımını iyileştirmek için bazı ilginç işlevler ve geometriler sunmamızı sağlıyor" dedi. "Bu malzeme aynı zamanda 224G'nin ötesine geçen ve hatta 448G'ye ulaşan yüksek hızlı diyotları mümkün kılabilir." Tadayon, cam alt tabakaların benimsenmesinin, araçların ve süreçlerin geliştirilmesinin yanı sıra ortaya çıkan talebe bağlı olarak kademeli bir süreç olduğunu da sözlerine ekledi. Cam alt tabakalar organik alt tabakaların yerini almak yerine onlarla birlikte var olacaktır.

Intel Teknoloji Geliştirme Başkan Yardımcısı ve Paketleme ve Test Teknolojisi Geliştirme Entegrasyonu Direktörü Tom Rucker, şirketin gelişmiş paketlemedeki odağını çip üzerinde sistemden (SoC) paket içinde sisteme (SiP) kaydırdığını belirtti.
Rucker, "Ürün serilerimizin çoğunu Gömülü Çoklu Kalıp Ara Bağlantı Köprüsü (EMIB) teknolojisini kullanmaya geçirirken, bu değişim ivme kazanmaya devam ediyor" dedi. "Ayrıca, kalıp istiflemeyi destekleyen ve daha fazla sayıda kalıba izin vererek daha küçük geometriler ve daha yüksek performans sağlayan 3D ara bağlantılara doğru ilerliyoruz - hepsi tek bir paket içinde."

Pooya Tadayon, Intel Araştırmacısı, Paketleme ve Test Teknolojisi Geliştirme Direktörü
Büyük ölçekli paketlemenin getirdiği mekanik zorluklar da Intel'in bu alandaki yeteneklerini genişletmesine neden oldu. Tadayon, alt tabakaların eğilmeye eğilimli olduğuna dikkat çekerken, Intel Döküm Hizmetleri Gelişmiş Paketleme Kıdemli Direktörü Mark Gardner, bunun anakartlara montajı zorlaştırdığını sözlerine ekledi. Gardner, "Sonuç olarak, kart montajı konusunda uzmanlığa sahip olmanın müşterilerimiz için faydalı olabileceğini gördük ve onlar için sorunsuz bir süreç sağlamak için kart montajı üreticileriyle işbirliği yapabiliyoruz" dedi.
Ambalaj Teknolojisinde Sürekli İnovasyonu Teşvik Etmek
Intel'in yeni piyasaya sürdüğü ve yakında piyasaya süreceği ürünler arasında şunlar yer alıyor:
- Bu Max Serisi 2023'ün başlarında tanıtılan veri merkezi GPU'ları, yan yana 3D istifleme ve EMIB dahil olmak üzere Intel'in neredeyse tüm gelişmiş paketleme teknolojilerinden yararlanıyor. Bu bileşenler 47 adet 5nm işlem kalıbı ve 100 milyar transistör içeriyor.
- Yeni nesil 36µm aralıklı Foveros 3D istifleme teknolojisi (50µm'den 36µm'ye ve şimdi de 25µm'ye evrilmiştir) ve Meteor Gölü işlemcilerin 2023 yılında piyasaya sürülmesi bekleniyor.
- Bu Flip-Chip Ball-Grid-Array (FCBGA) 2024'te seri üretime geçmeyi hedefleyen platform, yan yana paket boyutlarını 100 mm'ye çıkarmayı, orta katmanları genişletmeyi ve hatveleri 90µm'nin altına indirmeyi planlıyor.
- Cam tabanlı bağlantı da dahil olmak üzere yeni nesil ara bağlantılar cam köprü teknoloji̇si̇-ve entegre dalga kılavuzları ile birlikte paketlenmiş optikler.
Tadayon, cam köprü teknolojisinin yeniden işlemeyi önlemek için optik fiberleri silikon çiplere doğrudan bağlamadığını veya yapıştırmadığını açıkladı. Bu "benzersiz çözüm" tak ve çalıştır işlevselliğini destekliyor ve 2024 yılı sonuna kadar seri üretime girmesi bekleniyor. Ayrıca Intel'in Foveros yonga istifleme teknolojisi de gelişmeye devam edecek ve hatvelerin 9µm'ye kadar küçülmesi bekleniyor.
Tadayon, "Gelecek nesil teknolojilere baktığımızda, ürünlerimizde 5µm'nin altındaki aralıkları benimsemeyi planlıyoruz" dedi. "Mimarların çipleri farklı şekillerde bağlamasına ve bu platformun sunduğu esneklikten yararlanmasına olanak tanıyan yeni mimariler ve 3D istifleme özellikleri sunmaya devam edeceğiz."
Bu Teknolojik Yenilikleri Ne Teşvik Ediyor?
Rucker, "Paketleme teknolojisi, yüksek performanslı süper bilgisayarlardan veri merkezlerine, uç bilişime ve aradaki her şeye (depolama, iletim ve veriye dayalı eylem) kadar ekosistemin tüm sektörlerinde bilgi işlem işlevlerinin etkinleştirilmesinde kritik bir rol oynamaktadır" dedi. "Teknolojik çözümler için temel itici güçler performans, ölçeklendirme ve maliyettir."

Mark Gardner, Intel'in dökümhane bölümünde gelişmiş paketleme kıdemli müdürü
Intel ayrıca "ya hep ya hiç" yaklaşımından uzaklaşarak dökümhane hizmetlerini de geliştiriyor. Gardner, şirketin ürün spesifikasyonlarından teste kadar tüm ürün üretim yaşam döngüsünü kapsayan daha esnek, alakart hizmetler sunan yenilenmiş açık sistem döküm modelini anlattı.
"Geçmişte üretim hizmetlerimizin tamamını kullanmanız ya da hiçbirini kullanmamanız gerekiyordu," diye açıkladı. "Ancak bu yeni yaklaşım talebi daha etkili bir şekilde karşılıyor ve daha fazla esneklik sunuyor." Ayrıca, testler artık üretim döngüsünün daha erken aşamalarında gerçekleştirilebiliyor ve bu da maliyetleri düşürmeye yardımcı oluyor.
Gardner, "Bu özellikle önemli çünkü Ponte Vecchio'ya (Max Serisi veri merkezi GPU'sunun kod adı) bakarsanız, yaklaşık 50 çip veya karoya sahip olduğunu görürsünüz" dedi. "Son test sırasında bunlardan biri arızalanırsa, çok pahalı ambalajlarla birlikte diğer tüm iyi kalıpları atmanız gerekir. Son test yeteneklerinden daha fazla kazanç elde etme potansiyelini gördük."
